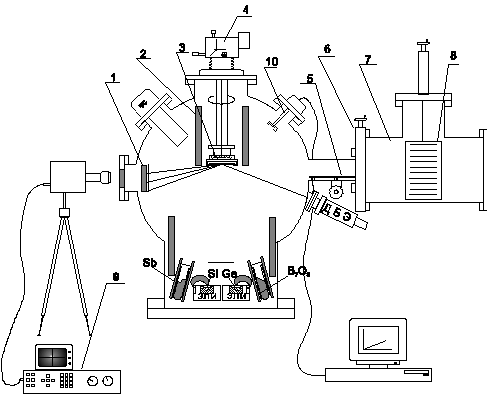
МИНИСТЕРСТВО ОБЩЕГО И ПРОФЕССИОНАЛЬНОГО ОБРАЗОВАНИЯ
РОССИЙСКОЙ ФЕДЕРАЦИИ
НОВОСИБИРСКИЙ ГОСУДАРСТВЕННЫЙ УНИВЕРСИТЕТ
Физический факультет
Ларченко Алексей Владимирович
1 курс, группа 0351
ОТЧЕТ
о курсовой работе
Изучение начальных стадий эпитаксии
Si на пористом кремнии (100)
Научный руководитель
Машанов В.И.
“__” 2001 г.
Преподаватель молекулярного практикума
Кихтенко А.В.
“__” 2001 г.
Новосибирск, 2001 г.
Введение
Гетероэпитаксия – это процесс нарастания кристаллической плёнки из одного вещества на подложке другого. Эффекты, возникающие при гетероэпитаксии, до сих пор до конца не изучены. Эта область в последнее время привлекает внимание исследователей, так-так при решении проблем, возникающих при гетероэпитаксии, станет возможным использовать хорошо себя зарекомендовавшие и удобные кремневые технологии с технологиями изготовления кристаллов из других материалов. Например, если удастся выращивать кристаллические плёнки GaAs эпитаксиальными методами, то это существенно снизит их стоимость и позволит массово использовать GaAs при изготовлении полупроводниковых приборов.
Оказалось, что пористый кремний (ПК) обладает замечательным свойством – подложки из него могут быть использованы для гетероэпитаксиального роста. Это стимулировало изучение гетероэпитаксии на ПК в ИФП СО РАН.
О гетероэпитаксии на пористом кремнии
Важное свойство пористых поверхностей – это возможность их использования в качестве податливой подложки при гетероэпитаксиальном росте. Как известно, несоответствие параметров решетки
Si и Ge достигает значения 4,2 %, поэтому при росте пленок возникают механические напряжения несоответствия, и с толщиной пленки возрастает запасенная в ней энергия. По достижению некоторой толщины, называемой критической, начинается релаксация упругих напряжений в системе пленка-подложка с появлением на ее границе раздела дислокаций несоответствия (ДН). Эти дислокации не только ухудшают кристаллическую структуру пленки, но и приводят к деградации электрофизических характеристик приборов. Во избежание такого эффекта используют структуру, где податливая подложка из пористого кремния подстраивается под постоянную решётки растущего кристалла и снимает напряжения внутри него. Пример такой структуры показан на рисунке 1.Методом анодного травления в плавиковой кислоте создаётся слой с пористостью 32%. Затем увеличивают ток, и создают слой с пористостью 65%. Из эксперимента известно, что кристалл из другого вещества, чем подложка получается качественнее, если его растить на ровной поверхности. Поэтому необходимо создать буферный слой из чистого кремния, представляющий собой ровную поверхность. Но при этом этот буферный слой должен быть очень тонким, дабы как можно меньше снизить амортизирующий эффект пористой поверхности.
Данная работа направлена на изучение условий создания гладкого буферного слоя.
Молекулярно-лучевая эпитаксия
Молекулярно-лучевая эпитаксия (МЛЭ) – это процесс выращивания плёнок на монокристаллической подложке в сверхвысоком вакууме
.При попадании атома на поверхность подложки он совершает миграции по поверхности и
, в конечном счете, встраивается в узел кристалла. Вероятность, с которой атом может путешествовать или встраиваться, определяется тепловой энергией атома, которую он приобретает при посадке на поверхность (зависит от температуры подложки T) и энергией связей с соседями (E). Как только два атома, мигрирующие по поверхности встретятся, то они образуют латеральную связь, а другие, упавшие на поверхность, атомы легко пристраиваются к этой паре, так как в этом месте связей с ближайшими соседями больше, чем на гладкой поверхности. Благодаря этому эффекту, при эпитаксии рост нового слоя начинается с зарождения островков. Последующие атомы встраиваются в края островков, что приводит к росту островков. В дальнейшем островки соединяются друг с другом. Таким образом происходит полное зарастание начального слоя. В то время, когда последние вакансионные островки в формируемом слое зарастают, уже начинают образовываться новые островки на старых, совокупность которых составляет почти сформировавшийся слой кристалла. Таким образом, происходит послойный рост кристалла со структурой, повторяющей кристаллическую структуру подложки.
Описание установки молекулярно-лучевой эпитаксии “Катунь-С”
Принципиальная схема установки для молекулярно-лучевой эпитаксии “КатуньС” приведена на рисунке 2.
Автоматизированная многокамерная установка молекулярно-лучевой эпитаксии “Катунь” предназначена для получения многослойных эпитаксиальных плёночных структур в условиях сверхвысокого вакуума. Основные части которой включают в себя: модуль загрузки-выгрузки, транспортный узел и модуль для эпитаксии.
Модуль загрузки-выгрузки предназначен для загрузки, выгрузки и транспортировки полупроводниковых подложек в сверхвысоковакуумную установку. В модуле так же производится первичное обезгаживание подложек. МЗВ состоит из вакуумной камеры, вакуумных насосов, двух манипуляторов со спутниками для
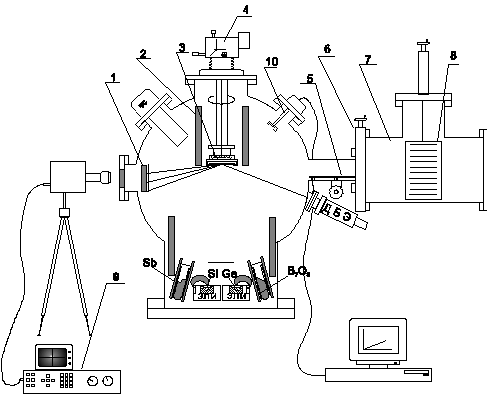
Рис.2 – Установка молекулярно-лучевой эпитаксии “Катунь-С”.
подложек, натекателя и датчиков давления. Модуль позволяет одновременно загрузить 20 подложек диаметром до 100 мм.
Транспортный узел предназначен для перемещения рейки с подложками из МЗВ в камеру роста.
Модуль эпитаксии моноатомных полупроводников позволяет производить эпитаксиальный рост моноатомных полупроводников и осуществлять легирование в процессе роста. Модуль содержит в себе следующие устройств: вакуумная камера, система насосов, манипулятор с нагревателем, блок испарителей, датчик масс-спектрометра, криопанель, датчики давления, дифрактометр быстрых электронов, кварцевый измеритель толщины.
Вакуумная система нужна для создания необходимого рабочего давления в модулях и сосоит из насосов форвакумного, адсорбционного, сублимационного и магниторазрядного, обеспечивая пределное остаточное давление 1*10
-8 Па.Манипулятор с нгревателем предназначен для захвата подложки и ориентировки её относительно молекулярных пучков и аналитических приборов, а так же для нагрева и вращения подложки во время эпитаксии. Нагрев положки осуществляется тепловым излучением нагревателя, который окружёт системой многослойных экранов для уменьшения излучения на стенки камеры. Максимальная температура негрева подложек 1100 С.
Блок испарителей является одним из основных узлов технологических модулей и предназначен для получения молекулярных пучков. Блок включает в себя два электронно лучевых испарителя (ЭЛИ)
Ge и Si, две молекулярных ячейки Sb и B2O3 и криопанель. ЭЛИ позволяет получать молекулярные потоки веществ, имеющих высокую температуру испарения или требующих испарения из автотигелей из-за большой химической активности. Ячейки Кнудсена создают молекулярный поток за счёт нагрева тигля с испаряемым веществом. Конструкция ячеек позволяет получать температуры на тигле испарителя в диапазоне 0-1300 С, с точностью поддержания температуры +/-0.5 С.При эксперименте образец загружается в модуль загрузки-выгрузки, там обезгаживается, затем по транспортной рейке поступает в модуль для эпитаксии. Там он устанавливается под нагревателем. Нагреватель доводит его до нужной температуры. Открываются заслонки ячеек с осаждаемым веществом (Si, Ge), молекулы которого испаряются, вылетают и попадают на подложку, где и проходит процесс эпитаксии.
Описание эксперимента
Как уже говорилось, первоначальной целью эксперимента являлось создание гладкого буферного слоя на поверхности пористого кремния. Для роста было подготовлено 2 образца. Методом анодного травления создавались шайбы с пористостью 32% на глубине до 1000 А, далее лежал слой 65% пористости толщиной 1 мкМ. Здесь и далее проценты пористости указаны по доле массы, какую имеет образец, по сравнению с массой непористого вещества.
После загрузки образцов в камеру и предварительного обезгаживания они поступали в камеру для эпитаксии.
1ый образец: В камере образец постепенно нагревался до 780 С. При этом, с него сублимировала оксидная защитная плёнка (
SiO2). После термической очистки были открыты заслонки нагретой ячейки с Si, и начался процесс эпитаксии. Скорость роста постепенно увеличивалась с 1.5 до 3 А/мин. (0.5 – 1 атомный слой в минуту). Наблюдение за образцом велось с помощью дифракции быстрых электронов на отражение (ДБЭО).На 13 минуте после начала термообработки на картинке ДБЭО были замечены прямые “тяжи” (Рис. 3), свидетельствующие о наличии сверхструктуры в образце.

Рис. 3 Фотография ДБЭО образца. Прямые “тяжи” свидетельствуют о наличии сверхструктуры в образце. Имеет место трансляционная симметрия, следовательно, образец представляет собой правильную кристаллическую структуру. Это стандартный вид ДБЭО картинки для кристалла типа алмаза на поверхности (100
).Это значит, что поверхность полностью отчистилась от плёнки оксида и теперь рост идёт на поверхность кремния.

Рис. 4 Фотография ДБЭО. Чётко видно появление “боковых тяжей”. Особенно интересный левый рефлекс. Там видны сразу 2 тяжа. Это говорит о наличии нескольких дополнительных граней на поверхности образца.
Рост первого образца проводился в течение 60 минут, и была выращена плёнка толщиной ~ 190А.
2 ой образец: Эксперимент на втором образце проводился при температуре 800 С и скорость осаждения с самого начала роста была выставлена 3 А в мин. Никаких качественных изменений, по сравнению с первым экспериментом, на картинах ДБЭО не наблюдалось. Процесс только шёл быстрее.
Анализ результатов эксперимента
Первым указанием на то, что в результате эксперимента не удалось создать гладкий буферный слой, было продолжительное присутствие “боковых тяжей”. Они не исчезли даже к концу эксперимента. Это говорило, о наличии граней островков, разориентированных с поверхностью (100). Теоретически, при зарастании пор, сначала должны были образоваться “боковые тяжи” – появляются плоскости внутри пор – начало зарастания, а потом, когда поры зарастут полностью, плоскости исчезают и “тяжи” вместе с ними. Этого не наблюдалось.
Предположения о сложной морфологии поверхности подтвердил анализ образцов АФМ-микроскопией. Ниже приведены фотографии, полученные с помощью АФМ.
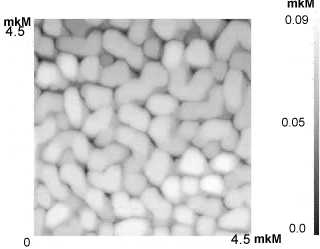 Рис. 5 Вид поверхности АФМ микроскопом. Чётко видна неоднородность поверхности. Наблюдаются “островки” и “канавки”. Средняя высота “островков” примерно 700 А. При том, что толщина выращенной плёнки составляла 190 А. Это говорит, о том, что пористая подложка изменила свою структуру в процессе эксперимента. Мы имеем дело не с выращенными “островками”, а с трещинами пористой структуры.
Рис. 5 Вид поверхности АФМ микроскопом. Чётко видна неоднородность поверхности. Наблюдаются “островки” и “канавки”. Средняя высота “островков” примерно 700 А. При том, что толщина выращенной плёнки составляла 190 А. Это говорит, о том, что пористая подложка изменила свою структуру в процессе эксперимента. Мы имеем дело не с выращенными “островками”, а с трещинами пористой структуры.
Обращает на себя внимание факт, что при напылении плёнки толщиной 190 А наблюдаются “островки” высотой
~ 700 A. При том, что структура имела пористость 32% на глубине до 1000 А, можно сделать вывод об изменении структуры этого слоя. Во время термической обработки подложки на стадии подготовки к эпитаксиальному росту из-за высокой температуры произошло спекание пористой структуры в “островки”, состоящие из чистого Si. Таким образом, к моменту начала эпитаксиального роста подложка уже не представляла пористую поверхность. Рост плёнки шёл на подложку, имеющую высокие островки. Это объясняет факт продолжительного наблюдения боковых “тяжей” на ДБЭО картинах. Значит, для выращивания качественного буферного слоя, необходимо сначала решить проблему, связанную со спеканием подложки. Следующие рисунки более подробно иллюстрируют морфологию поверхности.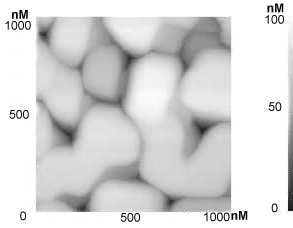 Рис. 6 и Рис. 7 показывают поверхность образца в меньшем масштабе. Отчётливо видны контуры островков.
Рис. 6 и Рис. 7 показывают поверхность образца в меньшем масштабе. Отчётливо видны контуры островков.

Чтобы избежать нежелательных процессов спекания пор можно попытаться, при изготовлении подложки, не наносить защитную плёнку из
SiO2. Эта плёнка наносится на поверхность сразу после анодного травления, чтобы деактивировать оборванные связи у атомов Si в кристалле. Если этого не делать, то при экспозиции подложки на воздухе внутрь кристалла могут попасть различные чужеродные атомы ,ухудшающие свойства кристалла. Кроме того, если поверхность вступит в реакции с соединениями углерода, то образованные связи будет невозможно разорвать впоследствии. Плёнка из SiO2 уходит с поверхности кремния при температуре ~ 780 C. Вместо неё можно попробовать деактивировать оборванные связи кремния атомами водорода. Водород уходит с поверхности при более низкой температуре (~ 400 C), поэтому его возможно удалить быстрее, чем SiO2. Ещё, можно попробовать наносить более тонкие пленки из SiO2 на стадии подготовки подложки, но тогда существует риск ненадёжной защиты кристалла от атмосферной среды.
Выводы
Список литературы
[1] Estrup P.J., McRae E.G. Surface studies by electron diffraction, Surface Science, 1971, V.25, N1, pp.1-52.
[2] Hernandez-Calderon I., Hochst , Physical Review B, 1983, V.27, N.8 ,pp.4961-4965.